- Главная
- Оборудование для печатных плат
- Оборудование для поверхностного монтажа
- Технологии производства плат и поверхностного монтажа
- Инструмент для печатных плат и Запасные части
- Материалы и Химикаты для печатных плат и поверхностного монтажа
- Гальваническое оборудование
- Лабораторное и аналитическое оборудование
- Сервис и техническое обслуживание
- Как нас найти
- Начало раздела
- Оборудование
- Поддержка
- Справка
- Контакты
Перспективы развития техники печатных плат и микросборок «Что было — что будет»
С точки зрения технологии формирования коммутационных плат (подложек) микросборки могут быть разделены на три больших группы:
- Коммутационные платы, изготовленные с использованием тонкопленочной технологии (технологии напыления металлических слоев, с изоляцией, наносимой напылением или поливом).
- Коммутационные платы, изготовленные с использованием толстопленочной технологии получения проводящего рисунка (технологии «зеленой керамики» — LTCC и технологии вжигания металлических и изоляционных паст — HTCC).
- Коммутационные платы, изготовленные с использованием спрессованных через склеивающие прокладки фольгированных материалов (традиционная технология многослойных печатных плат, включая технологию послойного наращивания).
К категории микросборок, при изготовлении которых использовалась тонкопленочная технология в ее классическом варианте, следует отнести бесчисленное разнообразие ГИС на ситаловых подложках (для обеспечения точности встроенных резистивных элементов), микросборки «Эльбрус2» на поликоровых подложках (для обеспечения эффективного теплоотвода) и микросборок на кремниевой подложке. Варианты этих конструктивов упоминались в предыдущей части статьи, и для стройности изложения хотелось бы повторить их иллюстрации и основные характеристики (рис. 10, 11, ТвЭП № 6`2011, стр. 50).
Все эти конструктивные типы микросборок имеют следующие особенности:
- Разводка в 2–3 уровнях.
- Тонкопленочные проводники с высоким погонным сопротивлением в связи с формированием проводниковых слоев из напыленного алюминия толщиной 1–2 мкм.
- Относительно небольшие габариты: 48х48 мм максимум.
- Возможность формирования прецизионного рисунка.
- Отсутствие волновых сопротивлений.
- Относительно низкий процент выхода (в связи с затруднительностью восстановления дефектных связей).
- Наличие рельефа напыленных структур, являющихся слабым местом с точки зрения обеспечения надежности.
- Необходимость корпусирования и герметизации (из-за того, что тонкие слои коррозионнонестойкого алюминия не работают в атмосфере).
К этим типам можно отнести микросборки на базе технологии «Прима» и технологии внутреннего монтажа: при их изготовлении используется напыление тонких слоев меди с последующим гальваническим наращиванием и формирование изоляционных слоев поливом фотоформируемого диэлектрика с последующим шлифованием (технология «Прима»), либо использование различных видов диэлектрика, переходы в котором формируются ионноплазменным травлением через маски (рис. 1, 2).
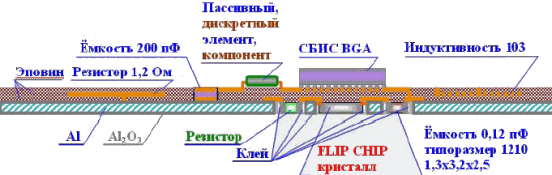 |
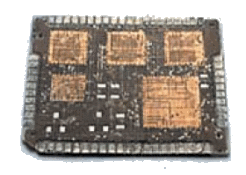 |
|
Рис. 1. Вариант компоновки микросборки по технологии «Прима»
|
Рис. 2. Коммутационная плата, изготовленная
по технологии внутреннего монтажа
|
Следует отметить, что эти технологии позволяют формировать структуры со встроенными активными элементами (кристаллами ИС) и соединениями без пайки, что, конечно, является их преимуществом, но при этом обладают и рядом технологических недостатков, к которым следует отнести:
- необходимость решения вопроса точного совмещения встраиваемых кристаллов с коммутационным рисунком;
- наличие в техпроцессе «Прима» операции прецизионного шлифования медных слоев, требующей нестандартного оборудования и инструмента;
- использование в технологии внутреннего монтажа сложных металлических рамок для ионноплазменного травления и напыления.
К безусловным преимуществам технологии внутреннего монтажа следует отнести большую инвариантность в выборе материала подложки и материала межслойной изоляции. При всех перечисленных выше технологических и конструктивных преимуществах и недостатках варианты конструктивов микросборок на основе тонкопленочной технологии имеют еще один недостаток, существенно снижающий их привлекательность для интегрирования в РЭА. А именно — отсутствие доступных и универсальных САПР (CAD), позволяющих проектировать и встраивать тонкопленочные микросборки в традиционные электронные модули РЭА, в том числе с использованием устройств моделирования.
В последнее время интенсивно развивается и внедряется технология и конструкция керамических многослойных коммутационных подложек на основе низкотемпературной (температура спекания до 850 °C) керамики (LTСС) (рис. 3, 4).
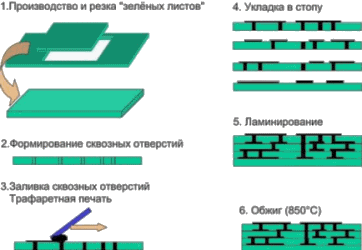 |
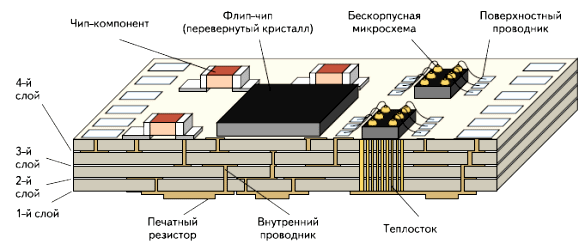 |
|
Рис. 3. Технология изготовления LTCC-подложек
|
Рис. 4. Пример многослойной LTCC-структуры
со смонтированными элементами
|
Эта технология поддерживается пакетами соответствующих CAD и в отличие от технологии с использованием высокотемпературных (свыше 1000 °C) процессов спекания позволяет формировать проводники с низким погонным сопротивлением (на основе серебра, золота, меди), а также с нормированным волновым сопротивлением с учетом диэлектрической постоянной на уровне 6–8. Сейчас за рубежом активно обсуждаются и внедряются технологии встраивания активных компонентов в структуру многослойных печатных плат (как традиционную (рис. 5), так и послойного наращивания (рис. 6)).
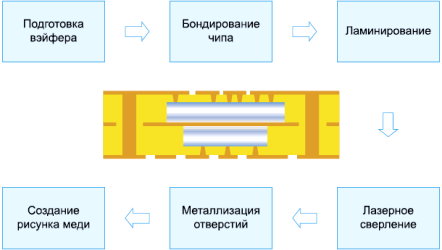 |
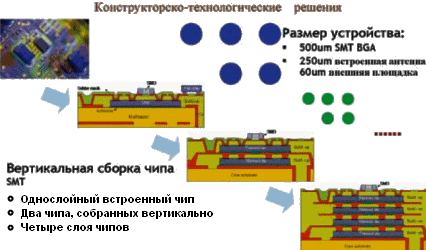 |
|
Рис. 5. Многослойная печатная плата со встроенными кристаллами
ИС (основные технологические операции)
|
Рис.
6. Многослойная печатная плата послойного наращивания
со встроенными, вертикально собранными ИС
|
Привлекательность этой технологии в том, что она поддержана всей существующей и довольно развитой инфраструктурой печатных плат (технологиями, материалами, СТО, НТД, САПР и т. д.). Обладая возможностью также формировать высоконадежные соединения без пайки, эта технология не лишена недостатков, основной из которых — принципиальная необходимость использовать тонкие (утонченные непосредственно перед встраиванием внутрь многослойных печатных плат до 0,08–0,1 мм) кристаллы ИС.
К микросборкам на базе многослойных печатных плат относятся также «системы в корпусе». Они широко рас пространены, особенно в конструктиве BGA (рис. 4, ТвЭП № 6`2011, стр. 49). При этом в качестве коммутационной платы (интерпозера по номенклатуре IPC) используется 6–8 - слойная сверхпрецизионная многослойная печатная плата на материале с низкими размерными изменениями. Использование «системы в корпусе» позволяет существенно ускорить разработки, реализуя функцию и отрабатывая конструкцию, при меняя элементы с меньшей степенью интеграции, переводя «систему в корпусе» в «систему на кристалле» с высокой степенью интеграции после внесения корректив без изменения конструкции электронного модуля в целом.
 |
|
Рис. 7. «Система в корпусе» на базе технологии АLOX
|
 |
|
Рис. 8. Компоновочные схемы «корпус
на корпусе»
|
Израильской фирмой МCL разработана коммутационная плата для «системы в корпусе» на базе технологии ALOX (рис. 7). Она представляет собой 3-слойную коммутационную высокотеплопроводную плату, разводка которой сформирована путем анодирования алюминиевой подложки на заданную глубину по рисунку, с последующим осаждением меди и фотолитографическим формированием прецизионного рисунка (рис. 13, ТвЭП № 6`2011, стр. 51).
Внедрение технологии ALOX предполагается на Владимирском заводе «Точмаш». Интересным развитием технологии «система в корпусе» является направление формирования трехмерных структур на основе таких систем, позволяющее существенно увеличить удельную плотность оборудования внутри электронного модуля.
На рис. 8 показаны наиболее часто встречающиеся компоновочные 3-мерные схемы типа «корпус на корпусе» (РоР). Сейчас в ассоциации IPC проводится активная работа по стандартизации конфигурации посадочных мест и габаритно присоединительных размеров элементов систем PoP. Разработка конструктивных вариантов ЭМ и МСБ, перечисленных в этой и предыдущих статьях, является только «надводной частью айсберга».
Отсутствие системного исследования и анализа конструктивных и технологических свойств существенно ограничивает их внедрение в практику отечественной раз работки РЭА. Как уже говорилось выше, вероятность внедрения того или иного конструктива зависит от того, насколько он поддержан инфраструктурой:
- Имеются ли для его реализации доступные расходные и базовые материалы.
- Насколько он вписывается в разработанные типовые и специальные техпроцессы.
- Имеются ли опытные и производственные участки, оснащенные СТО.
- Есть ли квалифицированные кадры, способные реализовать техпроцессы в соответствии с требованиями системы менеджмента качества.
Другими факторами, влияющими на востребованность той или иной конструкции, являются глубина опробования и отработка воспроизводимости технологических норм, которые могут быть использованы разработчиком. При этом должен быть обязательно реализован встречный процесс: разработка четких конструктивных требований и доказательство возможности воспроизводимой реализации предлагаемых техпроцессов.
Сочетание этих встречных задач является проблемой, определяющей фактор эффективности развития (в том числе и в мировой индустрии). В нашей стране он может быть реализован через создание технологических центров в рамках вертикально интегрированных структур. Такие технологические центры должны базироваться на центрах компетенции — точках роста технологической компетенции в том или ином направлении. Если бы такие технологические центры могли использовать для реализации типовых операций продвинутую технологическую базу центра компетенции, чтобы самим сосредотачиваться на реализации специальных инновационных операций, используя уникальное оборудование, которым их следует оснастить, то такой подход позволил бы существенно сократить затраты на модернизацию и ускорил бы инновационные процессы.
В части внедрения микросборок такой технологический центр целесообразно было бы разделить на три перечисленных выше на правления (тонкопленочная технология, технология многослойной керамики, технология прецизионных многослойных печатных плат) и реализовать их, обеспечив возможность использовать инфраструктуру соответствующих центров компетенции внутри вертикально интегрированных структур.




